摘要
在電子產品小型化的時代,高良率和低成本的集成電路(IC)載板,通過可靠的方法可實現芯片與電路板高密度互連(HDI)。為了最大化載板可用空間,應該最小化銅走線之間的距離——即線寬和線距(L/S)。常見PCB技術中線寬和線距大于40 μm,而目前采用更先進的晶圓級技術線寬和線距可達2 μm。在過去的十年中,芯片尺寸隨著載板上L/S顯著減小,這給印制電路和半導體行業均帶來特有的挑戰。
扇出型面板級封裝(FOPLP)是一種新的制造技術,旨在縮小PCB領域和集成電路/半導體領域的差距。雖然FOPLP仍然是一項新興技術,但該技術可提升面積使用率和產能,通過降低成本來提升競爭優勢,所以頗受市場青睞。在這個市場中,精細電路保證性能的關鍵是電鍍的均勻性或平整度。電鍍均勻性、走線/盲孔頂部平整度(測量走線頂部的平整度)及盲孔是其性能表現的特征。在多層電路加工中尤為重要,因為較低層上的不均勻性可能會影響到后續鍍層,從而破壞器件設計,導致諸如短路等災難性后果。另外,不平整表面會使連接點(即盲孔和走線)變形導致信號傳輸損耗。因此,不需要任何特殊后處理就能提供均勻平整輪廓的電鍍溶液是受行業期待的。
本文將介紹專用于IC載板的直流銅電鍍創新復合添加劑,可通過改進的圖形電鍍實現嵌入式溝槽填充,同時完成電鍍通孔及盲孔填充。這些新產品不僅可形成更好的走線輪廓,而且還可填充盲孔和電鍍通孔。我們還介紹了兩種電解銅電鍍工藝,可根據具體應用的盲孔尺寸和凹面要求來選擇:I號工藝可為直徑80μm 至120μm、深度50μm 至100μm的深盲孔提供良好的填充(圖1); II號工藝更適合于直徑50μm 至75μm、深度30μm 至50μm的小而淺的盲孔。
這兩種工藝可實現極佳表面均勻性和走線輪廓(圖2),本文將介紹給定參數在控制范圍內時所具備的盲孔填充和通孔電鍍性能,還介紹了如何優化電鍍金屬化散熱和物理特性。

圖1:通過增強圖形電鍍可同時進行盲孔填充和通孔電鍍的工藝性能

圖2:嵌入式溝槽填充性能,顯示焊盤和走線之間高度一致
引言
IC載板是PCB小型化技術領域中的最高水平,提供了IC芯片和PCB之間的連接,這些連接是通過導電銅走線和通孔的電氣網絡實現的。在消費電子產品的小型化、速度和便攜性方面,走線的密度是關鍵因素。在過去的幾十年里,走線密度已大大增加,為滿足包括薄芯材料、精細走線寬度和更小直徑的通孔和盲孔等當今印制電路設計要求,扇出型面板級封裝(FOPLP)的開發已成為微電子領域的熱門主題。
推動這項新技術的主要驅動力是成本和生產效率。傳統的扇出型晶圓級封裝(FOWLP)采用300 mm晶圓作為生產單位,因為獲得更大的晶圓非常困難,會增加加工步驟、人力和成本,同時良率較低。與晶圓相比,采用類PCB載板的優點是制造商具有設計靈活性和可用更大面積的面板。例如,610 mmx457 mm的面板幾乎是300 mm晶圓表面積的4倍,大大減少了成本、時間和加工步驟,這對于大批量生產來說是一個巨大的優勢。
然而,將FOPLP技術應用于基板需要進行更多的研究和開發,面臨分辨率和翹曲問題等挑戰。如果可成功實施,可實現更高的產量、更低的成本、更薄的封裝尺寸,使消費類電子產品更快、更輕。
酸性銅盲孔填充
電鍍工藝是生產電路板的關鍵步驟之一,通過電流分布實現PCB板上走線、盲孔及通孔的電鍍。作為首選導電金屬的銅具有成本低和導電性高的特點。隨著幾十年來電鍍銅工藝的發展,銅作為電鍍金屬的使用大大增加。先進的專用電路板設計需要尖端的電鍍設備和創新的電鍍溶液,所以在過去的幾十年中,噴流式電鍍設備已普遍使用。
電鍍填孔溶液通常為高濃度的銅(200 g / L至250 g / L硫酸銅)和較低濃度的酸(約50g / L硫酸)以促進快速填充。有機添加劑用于控制電鍍速率并獲得可接受的物理特性,必須仔細設計這些添加劑,以滿足客戶對導孔填充尺寸、良率、表面銅厚度、板面銅分布容差以及電鍍后盲孔的形狀等要求。典型的電鍍配方包含抑制劑、光亮劑和整平劑。理論上,可以僅使用包含抑制劑和光亮劑的雙組分系統填充盲孔,但是雙組分系統存在實際問題,例如大凹陷、敷形填充,以及工藝難以進行分析控制。
抑制劑和整平劑都起抑制作用,但起作用的方式不同。像抑制劑這樣的I型抑制劑可以通過光亮劑去活性,而II型抑制物如整平劑則不會去活性,載體通常是高分子量的聚氧烷基化合物。通常它們吸附在陰極表面并通過與氯離子相互作用形成薄層,因此載體通過增加擴散層的有效厚度來降低電鍍速率。陰極表面的能級被均衡(相同數量的電子可局部用于所有陰極表面點的電鍍),使得所生成的電鍍厚度分布更均勻。
另一方面,光亮劑通過減少抑制提高電鍍速率,它們通常是小分子量的含硫化合物,也稱為晶粒細化劑。整平劑通常由含氮的直鏈/支鏈聚合物和雜環或非雜環芳族化合物組成,這些化合物通常為四元結構(中心帶正電的原子及四個取代基),它們將選擇性地吸附在高電流密度位置,如邊緣、角和局部突起處,防止銅在高電流密度區域過量鍍覆。
測試方法
測試在8升電鍍槽和200升試驗槽中完成。不溶性陽極用于更高的適用電流密度、易于維護和均勻的銅表面分布。電鍍液在配置完成后,假性電鍍1Ah/L、分析、調整以校正添加劑濃度,然后進行電鍍測試,每塊測試板在電鍍前經過一分鐘酸清潔、一分鐘水洗和一分鐘10%硫酸濃度的酸洗。
操作條件和電鍍液成分
表1顯示了兩種配方的操作條件和最佳化的添加劑濃度。通常盲孔填充電鍍液以高銅和低酸來實現所需的孔底填充。
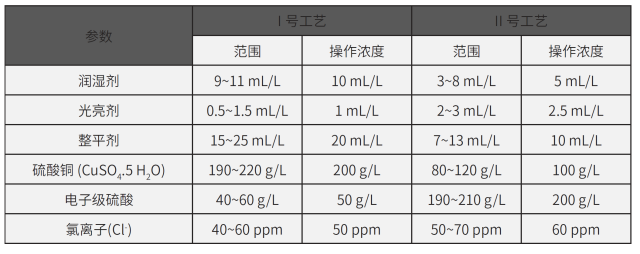
表1:電鍍液成分和電鍍條件
盲孔填充機理
盲孔內和板面上的銅生長速率由添加劑控制。圖3顯示了盲孔銅生長的示意圖,顯示了每種添加劑所起的不同作用。即使吸附局部擴大,在電鍍過程中也會發生選擇性和非選擇性吸附。必須將添加劑控制在表1所示的設定范圍內,以實現所需的“自下而上填充”。可以使用工業用常用分析工具進行分析,例如循環伏安剝離法(CVS)和霍爾槽測試。
在圖3中,綠色代表抑制劑、紅色代表整平劑、黃色代表光亮劑。潤濕劑分子主要吸附在表面上,抑制其中的電鍍,而由于帶正電的四級胺塩,整平劑選擇性地吸附在帶負電的區域上,這可以防止邊緣過度鍍覆并避免盲孔過早閉合,導致其中心形成空洞。光亮劑是一種含硫的小分子,可以更快地擴散到盲孔中加速電鍍,由于盲孔的幾何形狀在電鍍過程中連續變化,因此光亮劑在通孔內變得集中,導致盲孔中快速電鍍,這稱為曲率增強加速劑覆蓋(CEAC)機理。

圖3:CEAC機理示意圖(綠色代表抑制劑、紅色代表整平劑、黃色代表光亮劑)
最后,當盲孔內的銅電鍍接近與表面共面時,盲孔內和表面上的鍍覆率變為相等,自下而上的填充停止。具體取決于添加劑吸附和解吸的強度,光亮劑可能不會如預期地那樣擴散,高濃度的光亮劑將繼續加速電鍍,導致被稱為“沖力涌出”的過度電鍍。
細線路輪廓測量
圖4顯示了輪廓率和R值的計算,輪廓率被定義為最低點和最高點的高度差之間的比率,用百分比表示,而R值是焊盤區域和細線路之間的高度差,取兩個數值的最小值。

圖4:輪廓率和R值計算
I號工藝設計用于填充盲孔,形成平整的表面以及更好的走線輪廓率,對電鍍條件進行了優化,如表1所示。為了獲得所需的盲孔填充能力,將較高的CuSO4濃度(200g/L)與低硫酸(50g/L)相組合。
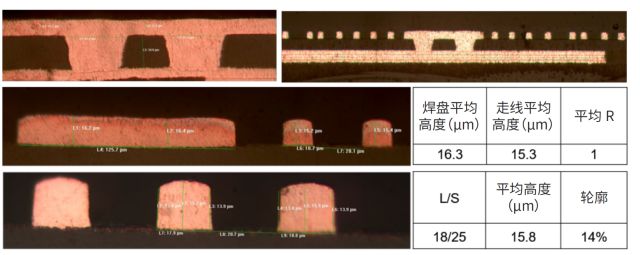
圖5:I號工藝的典型電鍍性能
I號工藝的典型性能如圖5所示,其中被填充的盲孔尺寸為60 μm×35 μm,而銅厚為15μm,由于I號工藝能夠以最小的凹面填充盲孔,因此不需要額外的平整化步驟。輪廓率范圍通常在10%至15%之間,然而,在一些情況下觀察到實際的情況是介于15%至20%之間,走線的鍍銅厚度為15μm 至16μm,R值在1~2之間。焊盤形狀更接近正方形并且表面平整,走線顯示出輕微的圓頂。

圖6:對90 μm x 25 μm、80 μm x 35 μm、90 μm x 60 μm和100 μm x80 μm不同尺寸盲孔的填充
針對該配方對不同尺寸盲孔的填充能力進一步評估。測試了4種不同的盲孔尺寸,分別為90 μm x 25 μm、80 μm x 35 μm、90 μm x 60 μm和100 μm x80 μm ,測試結果如圖6所示。對于90 μm×60 μm以下盲孔的填充,沒有觀察到凹面,然而較大的100 μm×80 μm盲孔具有4 μm的凹面。
電鍍液壽命研究
在初始性能評估后,將電鍍液老化至150 Ah/L,槽體積為8 L。每次電鍍的電鍍周期為15ASF,持續45分鐘,添加劑濃度與表1所列相同。
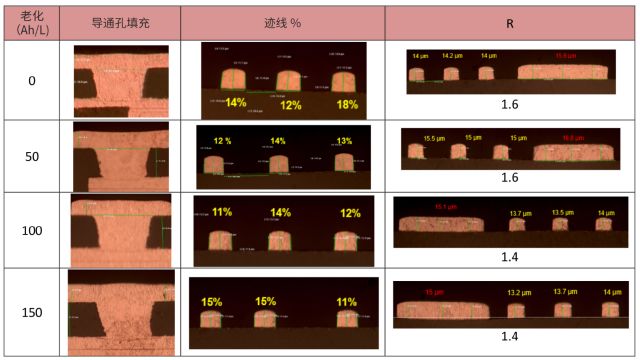
表2:電鍍液經不同的老化后(最高達150Ah/L),L/S為18 μm至25 μm的輪廓率及R值測試結果
在槽液老化測試過程中,每隔50Ah/L對測試板進行電鍍,制作剖切樣品,并在顯微鏡下評估。測試板由60 μm x35 μm盲孔和各種L/S走線組成。調整電鍍條件以在表面上獲得約15 μm的厚度。在整個老化過程中,走線輪廓率在10%~15%之間,偶爾出現15%~20%,與初始性能測試結果一致,平焊盤電鍍層的R值在1~2之間。
使用厚度為40μm和60μm電路板測試通孔填充能力。兩塊電路板的孔直徑分別為4 0μm和50 μm,結果如圖7所示,電鍍周期為1.24ASD,持續60分鐘,I號工藝在X型孔填充上表現非常出色。

圖7:I號工藝對X型孔的填充能力
抗拉強度和延伸率
PCB制造中兩個最重要的物理特性是電鍍銅導體的抗拉強度和延伸率,因為這些特性表明了銅金屬在組裝和最終使用過程中所能承受的熱應力。物理特性是添加劑其中包含抑制劑、晶粒細化劑和整平劑綜合影響的結果,這些性能還取決于電鍍速率或電流密度、電鍍溫度和晶體形態,例如,密集各種晶向沉積具有比柱狀沉積更好的物理性質。
根據IPC TM-650標準2.4.18.1測試方法測量物理特性,樣品再切成條狀并在125℃的爐中烘烤4~6小時,使用工業機械測試儀器測試樣品條,采用該儀器的測量值計算抗拉強度和延伸率百分比。圖8顯示了兩種不同老化電鍍槽液的結果:新電鍍液和約為100 Ah / L的老化電鍍液,從結果來看,隨著電鍍時間的增加,特性沒有太大變化,且符合IPC標準 III級要求。

圖8:I號工藝新電鍍液和老化電鍍液的物理特性、抗拉強度和延伸率
