封裝基板或中間層是BGA封裝中非常重要的部分,除了用于互連布線以外,還可用于阻抗控制及用于電感/電阻/電容的集成。因此要求基板材料具有高的玻璃轉化溫度rS(約為175~230℃)、高的尺寸穩定性和低的吸潮性,具有較好的電氣性能和高可靠性。金屬薄膜、絕緣層和基板介質間還要具有較高的粘附性能。
1.線鍵合PBGA的封裝工藝流程
(1)BGA基板的制備
在BT樹脂/玻璃芯板的兩面層壓極薄(12~18μm厚)的銅箔,然后進行鉆孔和通孔金屬化。用常規的PCB加3232藝在基板的兩面制作出圖形,如導帶、電極、及安裝焊料球的焊區陣列。然后加上焊料掩膜并制作出圖形,露出電極和焊區。為提高生產效率,一條基片上通常含有多個PBG基板。
(2)工藝流程
圓片減薄→圓片切削→芯片粘結→等離子清洗→引線鍵合→等離子清洗→模塑封裝→裝配焊料球→回流焊→表面打標→分離→最終檢查→測試斗包裝 芯片粘結采用充銀環氧粘結劑將IC芯片粘結在基板上,然后采用金線鍵合實現芯片與基板的連接,接著模塑包封或液態膠灌封,以保護芯片、焊接線和焊盤。使用特殊設計的吸拾工具將熔點為183℃、直徑為30mil(0.75mm)的焊料球62/36/2Sn/Pb/Ag或63/37/Sn/Pb放置在焊盤上,在傳統的回流焊爐內進行回流焊接,最高加工溫度不能夠超過230℃。接著使用CFC無機清洗劑對基片實行離心清洗,以去除殘留在封裝體上的焊料和纖維顆粒,其后是打標、分離、最終檢查、測試和包裝入庫。
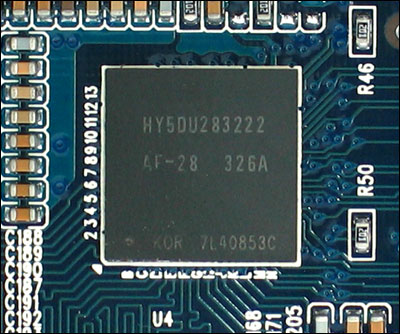
BGA封裝
2.C-CBGA的封裝工藝流程
(1)CBGA基板
FC-CBGA基板是多層陶瓷基板,它的制作是相當困難的。因為基板的布線密度高、間距窄、通孔也多,以及基板的共面性要求較高等。它的主要過程是:先將多層陶瓷片高溫共燒成多層陶瓷金屬化基片,再在基片上制作多層金屬布線,然后進行電鍍等。在CBGA的組裝中,基板與芯片、PCB電路板的CTE失配是造成CBGA產品失效的主要因素。要改善這一情況,除采用CCGA結構外,還可使用另外一種陶瓷基板--HITCE陶瓷基板。
(2)工藝流程
圓片凸點的制備呻圓片切割呻芯片倒裝及回流焊-)底部填充呻導熱脂、密封焊料的分配+封蓋斗裝配焊料球-)回流焊斗打標+分離呻最終檢查斗測試斗包裝。
3.線鍵合TBGA的封裝工藝流程
(1)BGA載板
TBGA載板通常是由聚酰亞胺材料制成的。在制作時,先在載帶的兩面進行覆銅,然后鍍鎳和鍍金,接著沖通孔和通孔金屬化及制作出圖形。因為在這種引線鍵合TBGA中,封裝熱沉又是封裝的加固體,也是管殼的芯腔基底,因此在封裝前先要使用壓敏粘結劑將載帶粘結在熱沉上。
(2)封裝工藝流程
圓片減薄→圓片切割→芯片粘結→清洗→引線鍵合→等離子清洗→液態密封劑灌封→裝配焊料球→回流焊→表面打標→分離→最終檢查→測試→包裝。
