通孔回流焊(THR)工藝因其能夠?qū)崿F(xiàn) SMT 與 THT 元件的一次性焊接,顯著提升生產(chǎn)效率而備受青睞。然而,在實(shí)際應(yīng)用中,許多企業(yè)仍面臨一系列工藝挑戰(zhàn)。本文基于行業(yè)實(shí)踐,梳理出 THR 工藝中十大常見問題,并提供詳細(xì)的原因分析與解決方案,幫助您系統(tǒng)性提升焊接質(zhì)量與可靠性。
一、錫珠(Solder Beading)問題
問題現(xiàn)象
在通孔焊點(diǎn)周圍或元件底部出現(xiàn)細(xì)小錫球,影響電氣絕緣可靠性,尤其在高壓應(yīng)用中存在短路風(fēng)險(xiǎn)。
成因分析
? 錫膏量過多,在回流過程中擠出形成錫珠;
? 預(yù)熱區(qū)升溫過快,溶劑揮發(fā)不充分;
? 錫膏黏度不足或金屬含量偏低。
解決方案
? 優(yōu)化鋼網(wǎng)設(shè)計(jì),通孔焊盤開口采用網(wǎng)格陣列或釋放槽模式,控制錫膏量;
? 調(diào)整回流曲線,預(yù)熱區(qū)升溫速率控制在 1.5–2.0℃/s,時(shí)間延長至 90–120 秒;
? 選用金屬含量 88%–92% 的 Sn96.5/Ag3.0/Cu0.5 無鉛錫膏。
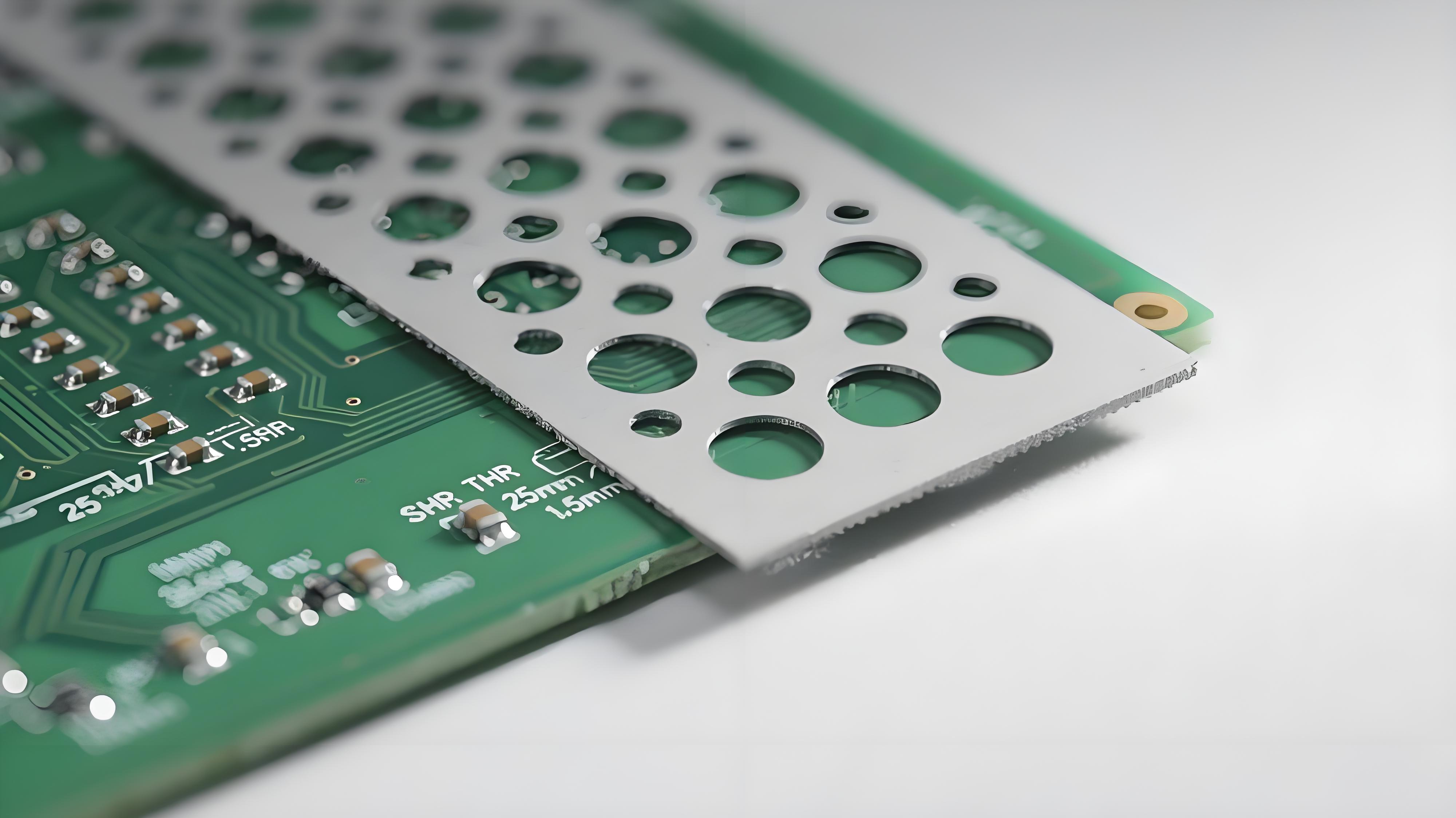
二、通孔填錫不充分
問題現(xiàn)象
通孔內(nèi)錫膏未完全填充,焊點(diǎn)強(qiáng)度不足,可能引發(fā)機(jī)械振動下的失效。
成因分析
? 錫膏量不足;
? 回流熱容量不夠,孔內(nèi)溫度未達(dá)液相線;
? 元件引腳與孔壁間隙過大。
解決方案
? 采用階梯鋼網(wǎng),通孔區(qū)域厚度增至 0.20–0.25mm;
? 提高回流峰值溫度至 240–245℃,并延長液相線以上時(shí)間至 60–80 秒;
? 控制引腳與孔壁間隙在 0.05–0.15mm 之間。
三、焊接橋連(Solder Bridging)
問題現(xiàn)象
相鄰焊點(diǎn)之間發(fā)生錫膏連接,導(dǎo)致電氣短路。
成因分析
? 錫膏印刷偏位或鋼網(wǎng)開口過大;
? 引腳間距過小(<1.0mm);
? 回流風(fēng)速過高,導(dǎo)致熔融錫膏流動。
解決方案
? 采用納米涂層鋼網(wǎng),提升錫膏釋放精度;
? 引腳間距小于 1.0mm 時(shí),鋼網(wǎng)開口內(nèi)縮 0.05mm;
? 降低回流爐風(fēng)速至 12–18 m3/min,減少熔錫流動。
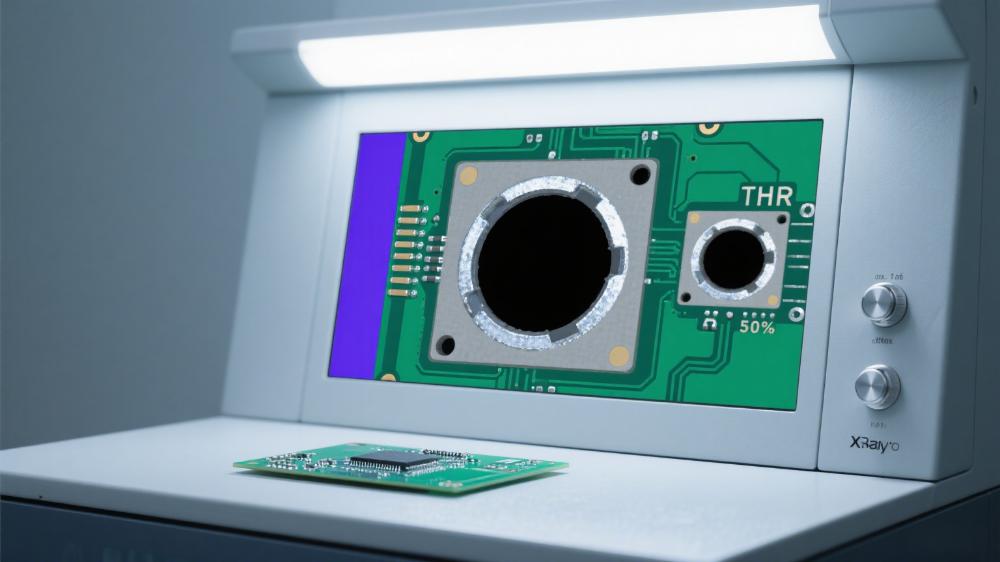
四、元件偏移(Component Misalignment)
問題現(xiàn)象
通孔元件在回流過程中發(fā)生位置移動。
成因分析
? 錫膏熔融時(shí)表面張力不均;
? 插裝精度不足;
? 回流爐軌道振動。
解決方案
? 選擇活性適中的 RMA 級助焊劑;
? 采用帶光學(xué)定位的自動插裝設(shè)備;
? 檢查回流爐軌道穩(wěn)定性,必要時(shí)加裝減震裝置。
五、通孔內(nèi)氣孔 / 空洞(Voids)
問題現(xiàn)象
X-Ray 檢測顯示孔內(nèi)焊點(diǎn)存在氣孔,影響導(dǎo)熱與機(jī)械強(qiáng)度。
成因分析
? 錫膏中溶劑揮發(fā)不徹底;
? 孔內(nèi)空氣受熱膨脹無法排出;
? 預(yù)熱時(shí)間不足。
解決方案
? 延長預(yù)熱時(shí)間至 100–130 秒,充分揮發(fā)溶劑;
? 鋼網(wǎng)開口設(shè)計(jì)增加排氣通道;
? 在引腳上增加細(xì)微凹槽(0.1mm 深)輔助排氣。
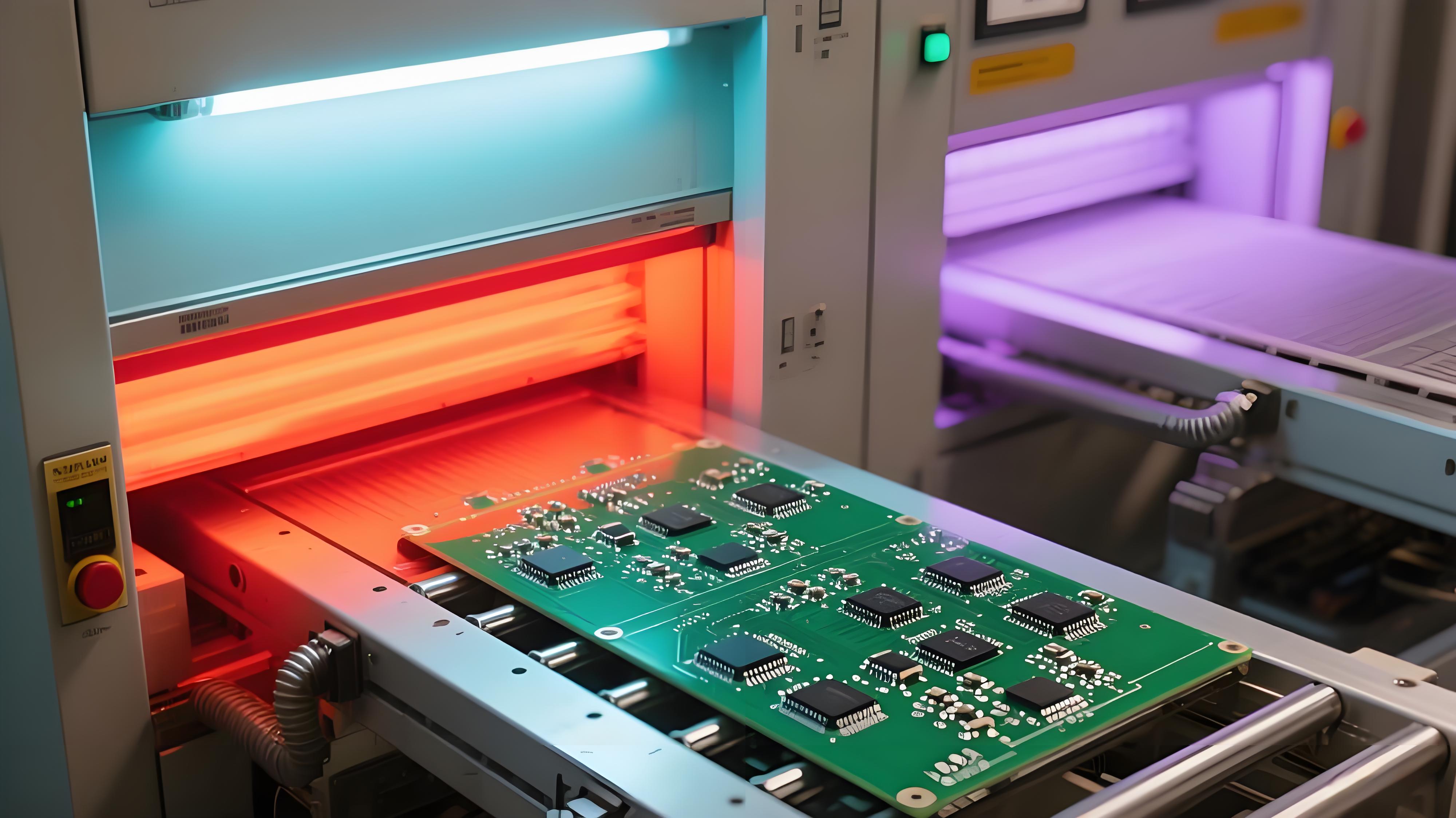
六、引腳露出高度不一致
問題現(xiàn)象
引腳伸出 PCB 板面的長度不一,影響后續(xù)操作與美觀。
成因分析
? 元件插裝深度未標(biāo)準(zhǔn)化;
? 引腳成型精度差。
解決方案
? 使用引腳成型模具,統(tǒng)一引腳長度;
? 設(shè)定插裝深度公差為 ±0.2mm,并做首件確認(rèn)。
七、焊點(diǎn)表面粗糙、無光澤
問題現(xiàn)象
焊點(diǎn)表面呈現(xiàn)粗糙、顆粒狀外觀,潤濕角偏大。
成因分析
? 峰值溫度不足或回流時(shí)間過短;
? 助焊劑活性不足或氧化嚴(yán)重。
解決方案
? 確保峰值溫度高于錫膏液相線至少 15℃;
? 選用活性更強(qiáng)的 OA 級助焊劑,并嚴(yán)格控制錫膏存儲條件(冷藏、回溫)。
八、助焊劑殘留過多
問題現(xiàn)象
板面殘留粘性助焊劑,可能引發(fā)腐蝕或絕緣不良。
成因分析
? 助焊劑固含量過高;
? 冷卻速率過慢,助焊劑未充分揮發(fā)。
解決方案
? 選擇低殘留型錫膏(固含量<40%);
? 提高冷卻區(qū)風(fēng)速,加速凝固過程。
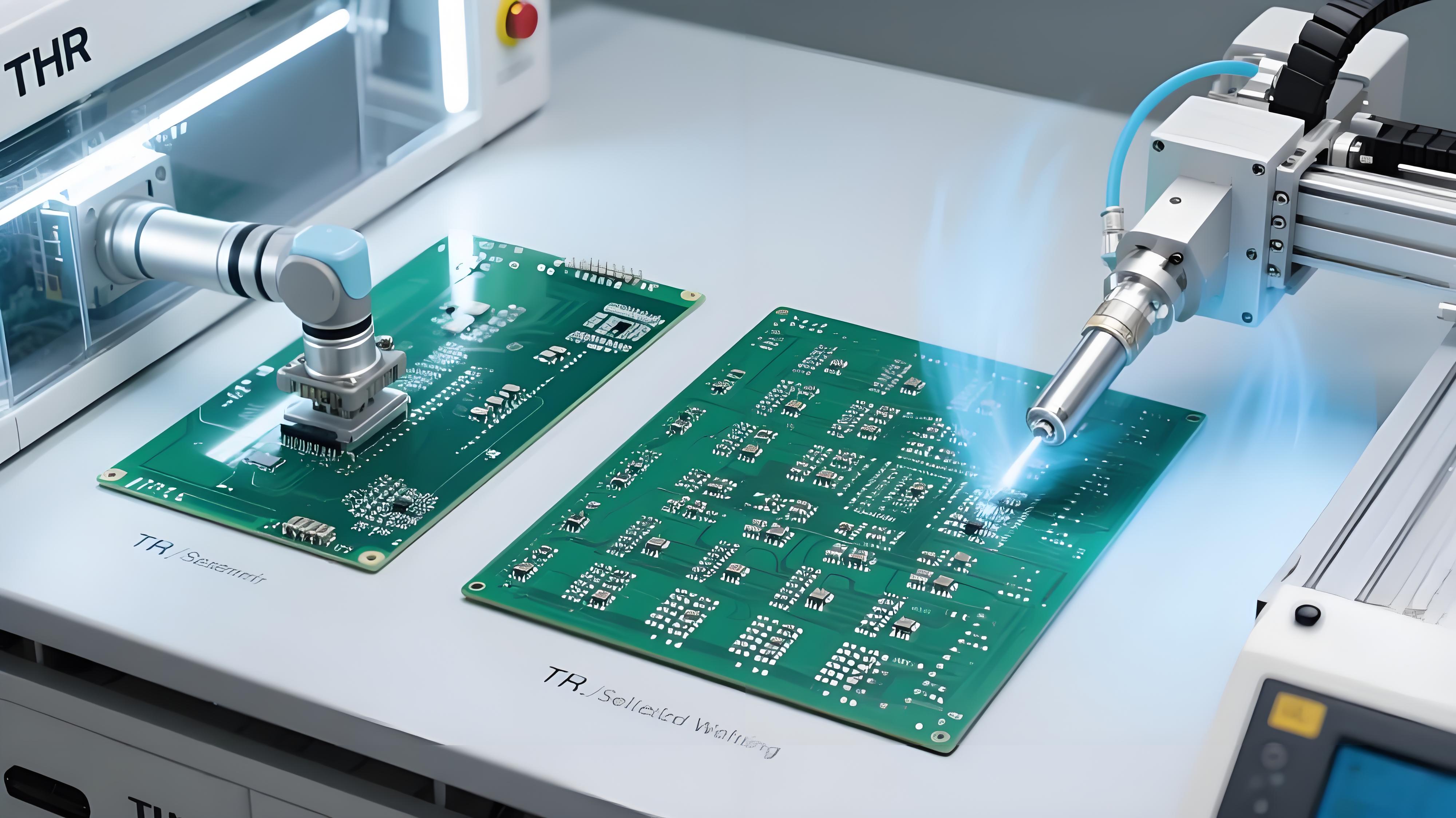
九、BGA 與 THC 共存時(shí)的熱沖擊問題
問題現(xiàn)象
同時(shí)焊接 BGA 與通孔元件時(shí),BGA 區(qū)域因熱容量大而升溫慢,導(dǎo)致冷焊或虛焊。
成因分析
? 熱分布不均,通孔區(qū)與 BGA 區(qū)溫差>10℃。
解決方案
? 采用分區(qū)加熱回流爐,對 BGA 區(qū)域單獨(dú)調(diào)高溫度;
? 在 BGA 底部添加熱補(bǔ)償蓋板,提升熱效率。
十、工藝選擇困惑:THR vs 波峰焊 vs 選擇性焊接
常見疑問
什么情況下應(yīng)選擇通孔回流焊?什么情況應(yīng)選擇波峰焊或選擇性焊接?
決策指南
工藝類型 | 適用場景 | 核心優(yōu)勢 |
通孔回流焊(THR) | PCB 單面有 SMT 和 THC 混合布局;追求生產(chǎn)效率與自動化;元件間距允許鋼網(wǎng)印刷 | 一次性完成焊接,流程簡化;自動化適配性強(qiáng),批量生產(chǎn)效率高 |
波峰焊 | 通孔元件數(shù)量多;PCB 板厚>3.0mm;產(chǎn)品屬于成本敏感型 | 設(shè)備投入相對較低;適配厚板與多通孔元件場景 |
選擇性焊接 | PCB 雙面混裝且僅局部區(qū)域有通孔元件;元件熱敏感性強(qiáng)(如熱敏電阻、傳感器) | 局部焊接精準(zhǔn),減少對敏感元件的熱損傷;適配復(fù)雜雙面混裝布局 |
結(jié)語:系統(tǒng)性優(yōu)化是關(guān)鍵
通孔回流焊工藝中的問題往往多因一果,單一環(huán)節(jié)的調(diào)整難以徹底解決問題,需從設(shè)計(jì)、材料、設(shè)備、工藝四方面建立系統(tǒng)性優(yōu)化體系:
1. 設(shè)計(jì)端:優(yōu)化 PCB 焊盤布局、通孔尺寸與元件間距,為工藝實(shí)施奠定基礎(chǔ);
2. 材料端:嚴(yán)格篩選錫膏(金屬含量、助焊劑類型)、鋼網(wǎng)(厚度、涂層)等核心材料;
3. 設(shè)備端:定期校準(zhǔn)自動插裝設(shè)備精度、回流爐溫度與風(fēng)速,確保設(shè)備穩(wěn)定性;
4. 工藝端:建立「鋼網(wǎng)開口 - 錫膏選型 - 插裝精度 - 爐溫曲線」的閉環(huán)控制,結(jié)合 SPC(統(tǒng)計(jì)過程控制)方法,實(shí)時(shí)監(jiān)控關(guān)鍵參數(shù)波動。
