先進(jìn)封裝是指處于當(dāng)時(shí)最前沿的封裝形式和技術(shù)。目前,帶有倒裝芯片(FC)結(jié)構(gòu)的封裝、晶圓級(jí)封裝(WLP)、2.5D 封裝、3D 封裝等被認(rèn)為屬于先進(jìn)封裝的范疇。
先進(jìn)封裝發(fā)展線路圖

從2018 年到2024 年,整個(gè)半導(dǎo)體封裝市場(chǎng)的營(yíng)收預(yù)計(jì)將以5.2%的復(fù)合年增長(zhǎng)率(CAGR)增長(zhǎng),而先進(jìn)封裝市場(chǎng)將以8%的復(fù)合年增長(zhǎng)率增長(zhǎng),市場(chǎng)規(guī)模到2023 年將增長(zhǎng)至400億美元。另一方面,傳統(tǒng)封裝市場(chǎng)的復(fù)合年增長(zhǎng)率則低于3.3%。在各種不同的先進(jìn)封裝平臺(tái)中,3D 硅通孔(TSV)和扇出型(Fan-out)封裝,將分別以29%和15%的速度增長(zhǎng)。而占據(jù)先進(jìn)封裝市場(chǎng)主要市場(chǎng)份額的倒裝芯片(Flip-chip)封裝,將以約8%的復(fù)合年增長(zhǎng)率增長(zhǎng)。與此同時(shí),扇入型晶圓級(jí)封裝(Fan-in WLP)主要受到移動(dòng)市場(chǎng)驅(qū)動(dòng),也將以8%的復(fù)合年增長(zhǎng)率增長(zhǎng)。
2018~2024 年全球先進(jìn)封裝技術(shù)市場(chǎng)規(guī)模預(yù)測(cè)情況(十億美元)

此外,前段晶圓制造與后段先進(jìn)封裝結(jié)合的趨勢(shì)日漸增強(qiáng)。全球晶圓制造大廠(如英特爾、臺(tái)積電和三星等)更是將先進(jìn)的晶圓制造技術(shù)與先進(jìn)封裝形式緊密結(jié)合,以強(qiáng)化集成電路產(chǎn)品制造的技術(shù)集成優(yōu)勢(shì)。受技術(shù)和規(guī)模兩方面的影響,全球封測(cè)產(chǎn)業(yè)集中度穩(wěn)步提升,2017 年前八大封測(cè)企業(yè)(含晶圓代工廠后段封裝業(yè)務(wù)部分)占據(jù)先進(jìn)封裝市場(chǎng)約87%的份額。
晶圓級(jí)芯片尺寸封裝(WLCSP)作為一類先進(jìn)封裝技術(shù),符合消費(fèi)電子發(fā)展的需求和趨勢(shì)(產(chǎn)品的輕小短薄化和低價(jià)化)。WLCSP 封裝與傳統(tǒng)封裝相比,其主要優(yōu)勢(shì)體現(xiàn)在:①WLCSP優(yōu)化了封裝產(chǎn)業(yè)鏈。傳統(tǒng)封裝方式是先將晶圓劃片成顆粒芯片,經(jīng)測(cè)試為合格芯片后,將其放到引線框架或封裝襯底(基板)上,而后再進(jìn)行封裝測(cè)試,產(chǎn)業(yè)鏈涉及晶圓廠、基板廠、封裝廠、測(cè)試廠。而晶圓級(jí)芯片尺寸封裝是先對(duì)晶圓進(jìn)行封裝、測(cè)試作業(yè),然后再對(duì)封裝測(cè)試后的晶圓進(jìn)行切割。相對(duì)傳統(tǒng)封裝,WLCSP 封裝能將傳統(tǒng)封裝的產(chǎn)業(yè)鏈中的基板廠、封裝廠、測(cè)試廠整合為一體,使得芯片生產(chǎn)周期大大縮短,提高了生產(chǎn)效率,降低生產(chǎn)成本;其次,WLCSP 封裝能減少封裝前合格芯片的測(cè)試環(huán)節(jié),能有效降低封裝成本;最后,WLCSP 封裝是晶圓制造技術(shù)的延伸,極大地縮小了半導(dǎo)體后段(即封裝)與前段(即晶圓制造)的技術(shù)差異,容易實(shí)現(xiàn)半導(dǎo)體后段與前段的技術(shù)對(duì)接。WLCSP 封裝可將IC 設(shè)計(jì)、晶圓制造、封裝測(cè)試、基板廠整合為一體,優(yōu)化了產(chǎn)業(yè)鏈,解決專業(yè)代工模式在IC 設(shè)計(jì)、晶圓制造、封裝測(cè)試、基板廠等各環(huán)節(jié)的技術(shù)與標(biāo)準(zhǔn)對(duì)接問(wèn)題,更加推動(dòng)了專業(yè)代工模式的發(fā)展。
2018 年應(yīng)用先進(jìn)封裝的晶圓數(shù)量(等效12 英寸)及各商業(yè)模式分布情況

②封裝成本隨晶圓上芯片數(shù)量增加而降低。晶圓級(jí)芯片尺寸封裝是在整片晶圓上進(jìn)行封裝后再切割得到芯片,而傳統(tǒng)封裝是將晶圓先切割成芯片后,再對(duì)芯片實(shí)施單獨(dú)的封裝。一般而言,WLCSP 的封裝成本是按照晶圓數(shù)計(jì)量的,與切割后的芯片數(shù)無(wú)必然聯(lián)系,而傳統(tǒng)封裝的封裝成本是按封裝芯片的個(gè)數(shù)計(jì)量的。因此,WLCSP 的封裝成本隨晶圓尺寸的增大和芯片數(shù)量增加而降低。在消費(fèi)類電子產(chǎn)品輕、小、短、薄化的市場(chǎng)發(fā)展趨勢(shì)下,晶圓級(jí)芯片尺寸封裝的成本優(yōu)勢(shì)愈加明顯,將逐步擠占傳統(tǒng)封裝的市場(chǎng)份額。
③WLCSP 將成為未來(lái)的主流封裝方式。業(yè)界認(rèn)為基于硅通孔(TSV)的三維封裝技術(shù)為是超越摩爾定律的主要解決方案,是未來(lái)半導(dǎo)體封裝技術(shù)發(fā)展趨勢(shì)。而WLCSP 封裝是硅通孔技術(shù)的基礎(chǔ),兩者工藝十分相似,通過(guò)掌握WLCSP 封裝技術(shù)(尤其是Shellcase 系列WLCSP)能快速進(jìn)入硅通孔技術(shù)領(lǐng)域,在未來(lái)三維封裝技術(shù)中扮演主要角色。
晶圓級(jí)芯片尺寸封裝與傳統(tǒng)封裝的區(qū)別
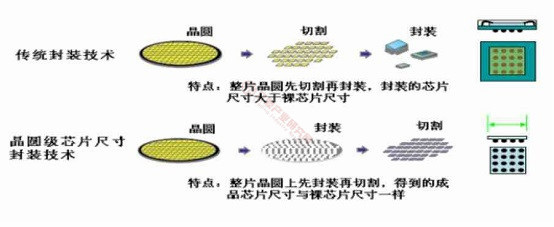
據(jù)Yole Development 預(yù)測(cè),WLCSP 封裝的市場(chǎng)容量將由2010 年的14 億美元左右增長(zhǎng)至2018 年的32 億美元,年復(fù)合增長(zhǎng)率為12%,占先進(jìn)封裝比例約11%,占全球封測(cè)業(yè)比例約6%。受益消費(fèi)電子、汽車電子等小尺寸芯片的需求拉動(dòng),我們預(yù)計(jì)2019 年WLCSP封裝市場(chǎng)容量約35 億美元,占比有望進(jìn)一步提升。
WLCSP 主要采用晶圓凸點(diǎn)封裝和Shellcase 系列WLCSP 兩種封裝技術(shù)。晶圓凸點(diǎn)封裝是一種技術(shù)難度相對(duì)較低的WLCSP 封裝形式,它的主要特點(diǎn)是在芯片正面直接引出電路及焊墊,而Shellcase 系列WLCSP 不僅可以在芯片正面直接引出電路及焊墊,也可以將芯片的電路引至芯片的背面后再制作焊墊,Shellcase 系列WLCSP 封裝包括了晶圓凸點(diǎn)封裝的技術(shù)要點(diǎn),其技術(shù)難度要高于晶圓凸點(diǎn)封裝,且工藝流程也較晶圓凸點(diǎn)封裝復(fù)雜。由于在技術(shù)難度和應(yīng)用領(lǐng)域上存在顯著差異,晶圓凸點(diǎn)封裝技術(shù)單價(jià)比Shellcase 系列封裝技術(shù)單價(jià)低。Shellcase系列WLCSP 在影像傳感器封裝上具有絕佳的優(yōu)勢(shì),而晶圓凸點(diǎn)封裝由于在芯片正面引出焊墊,無(wú)法應(yīng)用至影像傳感器等領(lǐng)域。
文章來(lái)自(www.ipcb.cn)愛(ài)彼電路是專業(yè)高精密PCB電路板研發(fā)生產(chǎn)廠家,可批量生產(chǎn)4-46層pcb板,電路板,線路板,高頻板,高速板,HDI板,pcb線路板,高頻高速板,IC封裝載板,半導(dǎo)體測(cè)試板,多層線路板,hdi電路板,混壓電路板,高頻電路板,軟硬結(jié)合板等